
"主要内容
在人工智能算力需求呈指数级增长的背景下,印刷电路板(PCB)作为服务器与数据中心硬件迭代的核心传输载体,正迎来前所未有的高景气周期。AI服务器与新能源车等下游应用的爆发式增长,使得高端PCB产品(如高多层硬板、HDI板)的单板价值量较传统产品提升3—5倍,推动产业格局持续优化,盈利能力显著增强。AI数据中心服务器已成为PCB需求增长最快的下游场景。
北美四大云服务商2025年资本支出总额将突破3300亿美元,微软、谷歌、亚马逊、Meta、甲骨文等公司持续加码AI基础设施,带动ASIC、GPU及交换机三大核心需求同步放量。其中,谷歌与亚马逊2025年ASIC卡采购量预计由2024年的300万张跃升至600万张;英伟达GB200/GB300机架方案出货将从2024年的3万架增至2025年的6万架;AI集群网络升级驱动交换机速率由800G向1.6T演进,进一步释放高多层PCB需求。
尽管各大厂商已陆续公布扩产计划并启动新增产能建设,但受制于高端设备交付周期显著延长、关键工艺突破尚需时间验证以及良率爬坡速度低于预期等多重因素,实际产能释放节奏明显滞后于需求扩张速度。由此,行业供需缺口在短期内难以有效弥合,产业链高景气状态有望贯穿全年。
PCB材料方面,AI硬件对传输性能、散热效率与集成密度的要求不断提升,PCB材料呈现“四高”趋势:迭代周期缩短、规格显著提升、材料等级加速优化、价值链上移。传统12—16层服务器板已演进至20—30层,HDI阶数由3—4阶提升至5—7阶;FR-4正快速让位于Df<0.002的Ultra-Low-Loss材料;高端CCL在成本中的占比由12%升至20%。石英纤维布、CCL覆铜板及HVLP铜箔、特种树脂、功能填料成为决定性能的关键瓶颈。
供给端方面,全球高阶材料产能高度集中。石英纤维布仅日东纺、圣戈班、菲利华三家具备航空级量产能力,2024年有效产能不足1500万m²,而2026—2028年AI需求预计达4000万—5000万m²;HVLP铜箔90%产能分布于日韩台,大陆厂商尚处验证阶段;M8及以上等级CCL供需缺口预计持续扩大。在此背景下,具备一体化优势与技术壁垒的国产材料龙头迎来国产替代与市场扩张的双重机遇。
AI算力革命正深刻重塑PCB产业链价值分布。需求端的持续高增与供给端的结构性瓶颈相互交织,推动高端PCB及上游关键材料进入长周期高景气阶段。把握技术升级与国产替代主线,将成为未来数年产业投资的核心逻辑。
"
 ]article_adlist-->
]article_adlist-->一、AI服务器需求强劲,
带动PCB迎来高景气周期
在AI算力革命驱动下,PCB作为服务器和数据中心硬件迭代中的核心传输载体,市场规模持续扩张。Prismark预测2025年全球PCB产值同比增长6.8%,而AI/HPC服务器PCB领域2023-2028年复合增长率高达32.5%。行业技术升级显著加速,高端PCB产品(如高多层硬板、HDI板)单板价值量较传统产品提升3倍-5倍,支撑了竞争格局优化与盈利稳定性。同时,下游新能源车(PCB用量为燃油车5倍以上)和AI服务器的需求爆发,进一步推动板块业绩增长,凸显其估值性价比优势
印刷电路板(PCB)作为“电子产品之母”,是所有电子产品的关键电子互连件,承担着支撑电子元器件、实现电气连接及数据传输的核心功能,其制造品质直接影响电子产品的稳定性和使用寿命。PCB下游主要应用于人工智能(AI)系统、服务器、存储设备、网络设备、AI终端等领域。随着AI技术及应用的迅猛发展,未来五年内,这些下游领域将成为推动PCB需求增长的主要动力。其中,AI数据中心服务器将是PCB需求增长最为迅速的领域。据Prismark预测,2024 - 2029年,数据中心服务器用PCB市场的复合年均增长率将达到11.6%,市场总需求将达到189亿美元,数据中心服务器用PCB市场将成为PCB下游的第一大应用领域;而有线侧网通(含交换机、光模块等)领域用PCB市场的复合年均增长率将达5.4%,高于行业整体增速,预计到2029年,该领域市场规模将达到80亿美元。
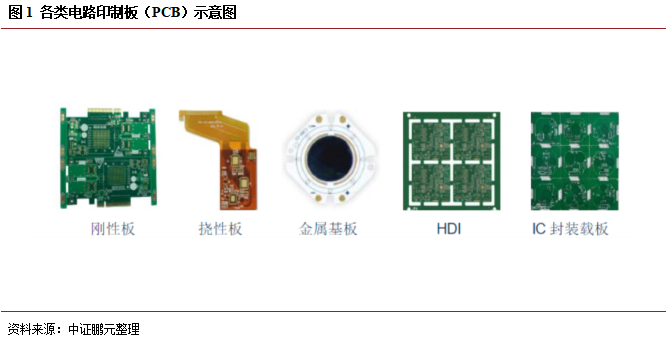

北美云服务商对2025年AI资本开支(Capex)普遍保持积极态度。根据彭博数据,微软预计2025财年资本支出有望突破848亿美元,其中2025财年一季度、二季度单季均将超200亿美元;谷歌将2025年Capex指引定为750亿美元,一季度已落地172亿美元,后续将继续加码服务器、数据中心与网络基础设施;亚马逊规划2025年Capex提升至1,000亿美元,绝大部分投向AWS相关业务以支持AI需求;Meta宣布2025财年资本支出区间上调至640–720亿美元;甲骨文预计,随着云基础设施收入增速由2025财年的50%跃升至2026财年的70%以上,公司Capex将在上一财年已增长三倍的基础上继续扩张至250亿美元,以匹配其云收入的高速增长。
展望2025年,PCB三大核心需求将同步放量:谷歌与亚马逊的ASIC卡采购量预计将由2024年的 300万张跃升600万张,实现翻倍;英伟达新一代GB200/GB300机架方案开始大批量出货,机架出货量有望从 2024年的3万架增至6万架;与此同时,AI集群网络升级带动交换机端口速率由800 G向1.6 T迈进,相关设备需求同步释放。


(1)ASIC芯片需求爆发
云厂商加速部署ASIC。为应对AI算力规模持续膨胀、降低对英伟达及AMD的依赖,全球主要云厂商正加速推进自研或与第三方协作的ASIC方案,以实现对成本、性能及供应链弹性的全面掌控
相较于传统 GPU,ASIC的核心优势在于其突出的性价比。ASIC采用高度定制化的芯片架构,可针对特定云服务商的业务场景及模型需求进行专属开发,将常用算子直接固化于硬件层面,从而在显著提升运算效率的同时有效降低功耗。此外,GPU领域的主流供应商(如英伟达)产品毛利率较高,而ASIC方案在晶圆级实现功能集成,有望进一步压缩单位算力成本。
目前全球云厂商所依托的 ASIC 设计服务主要集中在美系及台系企业:包括美国博通(Broadcom)、美满电子(Marvell),以及台湾世芯电子(Alchip)、创意电子(GUC)均占据重要份额;联发科亦有望在 ASIC 市场取得突破。考虑到美国对先进算力芯片出口管制持续收紧,国内云厂商预计将加速转向本土设计企业,以实现供应链安全与性能优化的双重目标。博通目前为全球 ASIC设计服务龙头,已斩获五家云级客户。公司预计,2025年起其中三家客户的ASIC将相继量产。2024财年,博通人工智能相关业务营收达122亿美元,同比增长220%,占其半导体总收入的41%。在 2024年3月的投资者交流会上,博通目前已获得五家ASIC客户预计至2027年人工智能可服务市场规模(SAM)将达到600–900亿美元。
为应对AI算力规模持续膨胀、降低对英伟达及AMD的依赖,全球主要云厂商正加速推进自研或与第三方协作的ASIC方案。其中,谷歌已发布TPU v6 Trillium,能效比与大型模型适配度显著提升,2025年将大规模取代TPU v5。其供应链由原先仅博通一家,新增联发科,形成“双供应商”策略。亚马逊当前主力为与Marvell共同设计的Trainium v2;下一代Trainium v3已携手Alchip(世芯)开发中。Meta携手博通研发MTIA v2,聚焦极致能效与低延迟架构。微软Maia系列专为Azure生成式AI负载优化,Maia v2设计已冻结。OpenAI计划采用台积电3nm与未来A16工艺流片,预计2026年底量产首颗ASIC。从采购规模来看,谷歌和亚马逊 2024年合计采购约300万张ASIC卡;2025年预计翻倍至600万张。Meta规划2025年部署100万张ASIC卡。


(2)英伟达新一代GB200/GB300机架方案开始大批量出货
2025年下半年,英伟达新一代Blackwell架构产品将全面进入放量周期:GB200机架方案将于第三季度起实现快速出货,GB300亦将在第四季度启动小批量交付,B200与B300系列芯片亦同步进入积极拉货阶段,标志着产业链已步入传统旺季。从设备交期来看,激光钻孔、真空压合等关键设备交期6–12 个月,2025 年新增产能要到下半年才能开出,缺口预计10–16%。从技术门槛来看,30 层以上 Ultra-Low-Loss CCL 全球仅三家能量产,大陆厂商扩产速度显著慢于需求增速,高阶材料(M8→M9)替代窗口进一步拉长景气周期。
产业链公司满产满销,2025年二三季度订单连续高增长。多家AI-PCB公司披露2025Q2业绩预告,沪电股份2025Q归母净利8.9–9.9亿元,同比增长42%~58%,环比继续提升;胜宏科技、东山精密、景旺电子同样订单饱满,处于满产满销状态。
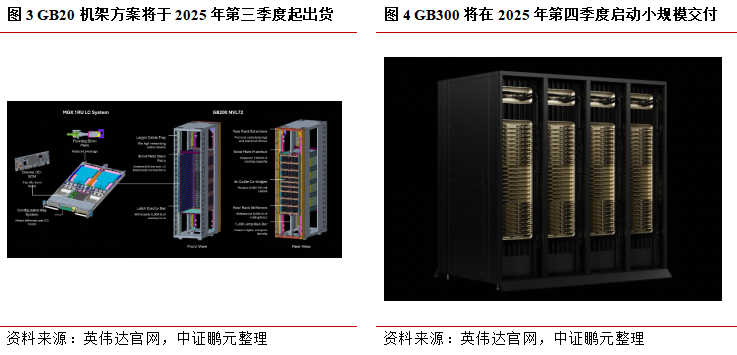
(3)单卡PCB价值量提升,交换机及机架出货量增长
PCB产业正在两大驱动力的共同作用下加速升级:一是人工智能对算力硬件提出更高规格要求;二是数据流量持续增长,倒逼基础设施持续迭代。上述趋势集中体现在服务器与交换机两类关键设备之上
在服务器侧,AI服务器相较于传统通用服务器新增了GPU模组。GPU对高带宽互联的需求,使得配套PCB及覆铜板(CCL)的规格全面提升:传统服务器 PCB层数为 14–24 层,AI 服务器已提升至20–30层;同时,AI领域开始大规模引入HDI(高密度互连)工艺,典型如英伟达GB200系列在核心算力模组中采用HDI设计,对PCB制造工艺提出更高要求。尤其在Meta的AI应用中,单卡PCB的价值明显上升。
在交换机侧,设备本身即由多张 PCB 构成,其性能瓶颈取决于整机总带宽。AI网络普遍采用Fat-Tree 架构,系统总带宽显著扩容:据产业链数据,25.6 T交换机需采用30层、Ultra Low Loss等级CCL;51.2 T交换机则需38–46层、Super Ultra Low Loss等级CCL。随着51.2 T高带宽交换机渗透率提升,高多层PCB 的需求将迎来显著增长。2024年AI机架出货量约为3万个,预计2025年将达6万个,实现翻倍增长,带动PCB及交换机需求。
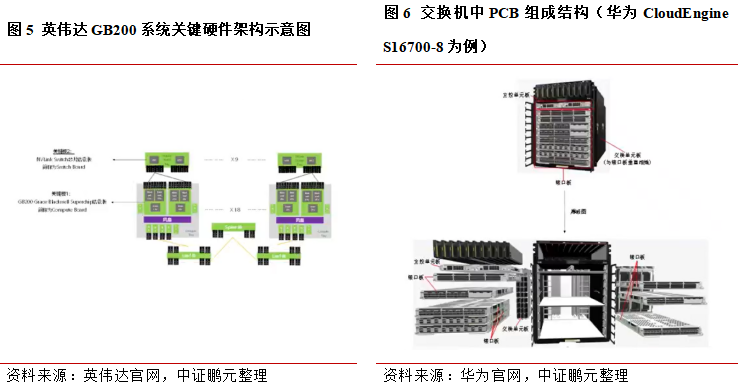
展望2025年,人工智能驱动的PCB产业链整体仍将延续供不应求的格局。尽管各大厂商已陆续公布扩产计划并启动新增产能建设,但受制于高端设备交付周期显著延长、关键工艺突破尚需时间验证以及良率爬坡速度低于预期等多重因素,实际产能释放节奏明显滞后于需求扩张速度。由此,行业供需缺口在短期内难以有效弥合,产业链高景气状态有望贯穿全年。

 ]article_adlist-->
]article_adlist-->二、PCB景气度向上游延伸,
关注石英纤维布、特种树脂、HVLP铜箔
和功能填料
随着人工智能技术的迅猛发展,对PCB的性能提出了更为严苛的要求,同时,其景气度也向上游材料领域延伸。此外,AI算力的升级促使PCB上游材料迈入“2.0时代”,需重点关注石英纤维布、特种树脂、CCL覆铜板、HVLP铜箔和功能填料这四大关键材料
PCB材料呈现出四大特征:
(1)迭代周期缩短
传统服务器和AI加速卡的迭代周期通常为3-4年,但在当前AI技术飞速发展的背景下,这一周期已大幅压缩至1-2年。以英伟达为例,其GPU代际间隔从2018-2022年的2年缩短至2024-2025年的不足1.5年。同时,AWS、谷歌、Meta等云厂商的AI芯片研发与推出速度也在加快。这种快速迭代的节奏要求PCB及其上游材料能够迅速契合新的技术要求,从而推动材料的持续升级换代。
(2)PCB规格提升
为满足AI算力的高要求,PCB的规格发生了显著改变。层数增多:传统服务器PCB层数一般为12-16层,而AI服务器PCB层数已提升至20-30层。层数的增加意味着PCB能够容纳更多的电子元件和更为复杂的电路,进而提升整体性能。HDI阶数提高:普通HDI技术的阶数从3-4阶跃升至5-7阶。HDI技术通过在PCB内部形成更密集的互连结构,能够有效提高信号传输速度和可靠性,减少信号干扰,以满足AI设备对高速数据传输的需求。
(3)材料等级优化
从传统的FR-4材料向Low-Loss(低损耗)甚至Ultra-Low-Loss(超低损耗,介电损耗Df<0.002)材料转变。随着信号频率的持续提高,传统材料在高频信号传输时的损耗问题愈发突出,而低损耗和超低损耗材料能够显著降低信号衰减,确保信号的完整性和传输效率。
(4)材料价值链上移
在PCB制造成本中,高端覆铜板(CCL)的成本占比从过去的12%提升至20%。石英纤维布、特种树脂、HVLP(高真空压合)铜箔和球形硅微粉等高端材料成为制约PCB性能提升的关键“瓶颈”环节。这些材料的性能直接决定了PCB的高频、高速传输能力以及整体可靠性,因此其在产业链中的价值不断提升,成为推动PCB行业升级的核心动力。
市场空间测算
(一)石英纤维布
石英纤维布作为一种高性能的绝缘材料,凭借其优异的介电性能和机械强度,在AI服务器和高速交换机的PCB中得到广泛应用。2025年,随着GB200NVL72等新型号的推出,单机PCB石英布用量约为6平方米。预计2026-2028年,AI服务器和1.6T交换机对石英纤维布的合计需求将达到4000万-5000万平方米,对应市场规模有望从2024年的约6亿美元增长至2028年的25亿-30亿美元,年复合增长率(CAGR)有望超过50%。这一巨大的市场空间将为石英纤维布供应商带来前所未有的发展契机。
石英纤维布市场目前呈现出“三足鼎立”的竞争态势,全球仅日本的日东纺、法国的圣戈班和中国的菲利华三家具备航空级批量供应能力。2024年,这三家企业的有效产能合计不足1500万平方米。菲利华作为国内唯一的“石英砂→纤维→织布”一体化企业,具有显著的成本优势和技术壁垒。其2024年织布产能为100万平方米,计划在2025-2026年新增100台喷气织机,预计到2027年总产能可达2000万平方米。菲利华的高端石英布收入在2024年达到3亿元,毛利率为45%。预计到2026年,其收入有望达到30亿-35亿元,毛利率维持在40%以上,未来三年具有3倍-5倍的市值增长空间。
石英纤维布在M7/M8/M9中的搭配逻辑?二代布采购量不足时如何取舍?
在AI服务器与800G以上交换机的PCB中,石英纤维布凭借极低介电常数与损耗成为核心增强材料。M7方案当前以Low-DK一代布为主,M8已可搭配一~二代布,进入M9后则必须升级到二~三代布才能满足插入损耗指标。然而,全球仅有日东纺、圣戈班与菲利华三家具备航空级批量能力,2024年三者合计有效产能不足1,500万m²,而2026-2028年AI场景需求预计达4,000-5,000万m²,缺口显著。在供应瓶颈下,客户更倾向于先升级铜箔而非继续拉高玻璃布等级,以规避二代布产能不足的风险。
(2)CCL覆铜板和HVLP铜箔
随着全球人工智能大模型的持续快速发展,高速运算场景对覆铜板(CCL)的要求日益严苛,高速CCL市场规模呈现快速增长态势,行业供应整体偏紧。覆铜板通常由基材、树脂和铜箔组成。其中,基材提供机械支撑和尺寸稳定性,常见的基材包括玻璃纤维布(如E玻璃纤维布)、合成纤维布等。树脂用于黏合基材和铜箔,同时提供电气绝缘性能。常见的树脂类型包括环氧树脂、双马来酰亚胺(BMI)、聚苯醚(PPO)和碳氢树脂等。铜箔提供导电路径,用于形成电路。铜箔的厚度通常在12微米到70微米之间,具体厚度根据应用需求而定。松下电工的Megtron系列作为高速覆铜板领域的分级标杆,通常被视为CCL行业的通行标准。目前,在通用服务器领域,随着EagleStream渗透率的提升,M6等级CCL已成为应用主流。然而,在AI服务器及400G-800G交换机等高性能计算场景中,M7和M8材料是主要使用材料。随着AI服务器的迭代升级以及800G交换机的量产,M8材料在AI领域的渗透率正在快速提升。M8材料的介电损耗(Df)约为0.0015,相较于M7材料(Df值约为0.002)降低了25%的传输损耗,是目前业内具备大规模量产应用的传输损耗、介电常数最低的材料,堪称AI算力领域高速板的关键材料,其平均售价(ASP)约为一般CCL(如FR-4)的5倍以上。根据Digitimes的数据,当前AI服务器与先进封装等领域对高阶CCL材料的市场需求在2024-2026年期间的年复合增长率(CAGR)为26%,而高阶CCL供给端的产能扩张CAGR仅为7%。因此,未来市场上高阶CCL的供需关系将维持较为紧张的态势。
M7、M8、M9树脂配方变化?M9是否会继续增加碳氢比例?PPO核心供应商有哪些?
树脂体系随材料等级呈阶梯式演进:M6及以下以BMI为主,单价约300元/kg;M7开始转向PPO-碳氢复合体系,其中PPO占比约30%,碳氢10%~15%,BMI降至5%以下,PPO单价约800元/kg。进入M9后,为追求更低Df与更好耐热性,碳氢比例还将再度提升,并与Q级石英布协同使用。国内PPO树脂主要由南通蓝星供应,海外则依赖沙比克;碳氢树脂国内合作方为星顺,海外为美日厂商。由于PPO与碳氢树脂单价远高于传统环氧,且配方切换需重新认证,客户往往优先通过微调铜箔/玻纤等级来延长现有树脂平台生命周期。
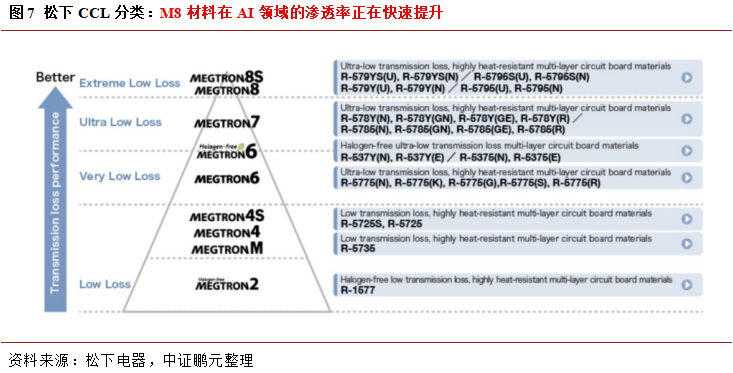
随着网络传输速率从400G向800G乃至1.6T迈进,交换机PCB对铜箔的性能要求也日益提高。单台1.6T交换机的铜箔用量从400G时代的0.4公斤增加至1.2公斤。2028年,全球HVLP铜箔的需求量预计将达到12万-15万吨。目前,全球90%的HVLP铜箔产能集中在日本、韩国和中国台湾地区,但中国大陆的德福科技、铜冠铜箔等厂商正在快速攻克5微米以下超薄规格的生产技术,有望在未来几年内显著提升市场份额。HVLP铜箔的加工费较传统铜箔高出30%~50%,预计2025年下半年起,其价格有望进入15万元/吨以上的区间,为相关企业带来丰厚的利润空间。
HVLP铜箔国产替代进程加速。HVLP铜箔的生产技术门槛较高,目前全球90%的产能集中在日本、韩国和中国台湾地区。然而,随着中国大陆厂商在超薄铜箔生产技术上的突破,国产替代进程正在加快。德福科技和铜冠铜箔等企业在5微米超薄铜箔生产技术方面取得进展。
铜箔市场空间与电子布相比如何?
M7与M8均为薄板,仅需添加一张玻璃布及少量树脂,铜箔的比重高于玻璃布或树脂。无论厚板还是薄板,两张铜箔为必要使用材料。然而,随着板材厚度减小,玻璃布和树脂的使用量相应减少,相对而言,铜箔所占比重会有所增加,目前已接近一半。
HVLP铜箔等级与材料对应关系?
HVLP铜箔与Megtron等级存在清晰映射:M7因成本敏感,现以RTF2/3为主,电信性能接近HVLP1;M8已普遍采用HVLP1/2,未来向HVLP3/4过渡;M9则必须搭配HVLP4/5才能满足插损指标。全球HVLP有效产能高度集中:日系三井、古河、福田及台系金驹占据高端市场,国内仅2-3家处于评估阶段,HVLP3/4尚未正式导入。由此导致海外加工费高达15万-20万元/吨,是国内6万-8万元/吨的2-2.5倍,国产替代空间巨大。
(3)特种树脂
特种树脂在PCB中发挥着关键的绝缘和粘结作用,其性能直接影响信号传输的稳定性和可靠性。随着AI硬件对高频、高速性能的追求,Df<0.002的Ultra-Low-Loss树脂需求快速增长。预计到2028年,全球Ultra-Low-Loss树脂的需求量将达到18万-20万吨,市场规模有望达到120亿-150亿元。目前,美国罗杰斯、日本松下等国际巨头长期垄断高端树脂市场,但国内的圣泉集团等企业正在加速布局,其2025年2万吨碳氢树脂产线即将投入运营,白科技的5000吨PPO树脂也将在2026年实现量产,有望打破国外垄断,提升国内特种树脂的自给率。高端树脂的单价可达8万-10万元/吨,毛利率高达35%~40%,远高于传统环氧树脂的2万-3万元/吨,具有显著的盈利优势。
(4)功能填料
功能填料在PCB材料中用于改善材料的机械性能、热性能和电性能。随着PCB传输速率的提高,高速材料的填充率从25%提升至45%,对功能填料的需求也相应增加。预计到2028年,全球球形硅微粉的需求量将达到60万-70万吨。目前,日本Admatechs和国内的联瑞新材形成双寡头竞争格局。联瑞新材正在积极扩大产能,计划在2025-2026年新增2万吨高端球形粉产能,以满足市场快速增长的需求。高端球形硅微粉的单价在2万-3万元/吨之间,毛利率可达30%~35%,具有较高的盈利水平。
功能填料与铜箔/电子布比例?
在超薄高速板中,功能填料用于降低树脂热膨胀系数并改善钻孔性能,其填充率由25%提升至45%。由于板厚持续缩减,铜箔重量占比已接近50%,填料与树脂、玻纤合计占比约50%,且随厚度下降铜箔权重继续上升。全球球形硅微粉2028年需求预计60万-70万吨,日本Admatechs与国内联瑞新材呈双寡头格局,后者2025-2026年将新增2万吨高端产能,单价2万-3万元/吨,毛利率30%~35%。
英伟达和谷歌跨材料搭配实例
NV的M9方案采用PPO-碳氢树脂+Q级石英布+HVLP4铜箔;亚马逊下一代产品提供两条路线:方案A升级二代布,方案B将铜箔由HVLP2提升至HVLP4;谷歌下一代则计划M8/M9树脂+二代布+HVLP2铜箔。客户升级策略遵循“先调铜箔/玻纤,再调树脂”的性价比路径,只有当铜箔与玻纤组合无法满足插损要求时,才会整体升级到更高等级的树脂体系。

作者 I 翁欣
部门 I 中证鹏元 研究发展部
关注公众号向后台留言可获得更多报告转载请标明出处
]article_adlist-->
欢迎关注#中证鹏元评级#视频号
]article_adlist-->新质生产力系列 | 电力设备2025年景气度延续,关注特高压+出海+AIDC
新质生产力系列 | 新能源汽车:整车智能化与能源低碳化的技术变革
新质生产力系列 | 固态电池产业链持续突破
新质生产力系列 | 军工:国防强军是大国刚需,大军工行业景气度恢复
新质生产力系列 | 关键矿产:大国博弈下中国关键矿产面临的挑战
新质生产力系列 | 量子计算:下一个AI?未来全球技术竞争关键点
新质生产力系列 | 自主可控:中美博弈下中国科技自主可控的新挑战
新质生产力系列|机器人零部件:国产化进程加速,PEEK轻量化材料需求爆发 (附转债)
新质生产力系列 | 机器人:华为、特斯拉巨头入局,AI驱动下机器人未来已来(附转债)
新质生产力系列 | 低空经济:引领新质生产力的万亿时代
新质生产力系列 | 半导体材料:行业复苏,高端材料国产化率有待提升
新质生产力系列:半导体设备:晶圆厂扩产带动行业复苏,国产替代加速(附转债)
新质生产力系列 | 数字经济:国产算力崛起,智算中心建设加速
新质生产力系列 | 锂电:行业底部待回暖,关注出海及固态、快充技术革新
新质生产力系列 | 电力设备:国内特高压建设加速,全球电力设备景气度周期共振
新质生产力系列 | 可控核聚变:人类能源问题终极途径,商业化进程加速
新质生产力系列 | 新通信:AI算力带动科技变革,ICT进入新一轮科技周期起点
新质生产力系列 | 光模块:AI算力驱动下光模块加速迎来1.6T时代,硅光渗透率有望提升
新质生产力系列 | 氢能:光储降价后绿氢平价进程加速,欧盟碳税加速绿氢发展
新质生产力系列 | 储能:国内大储需求高增,海外市场多点爆发
新质生产力系列 | 光伏:产能出清进行时,新一轮“双反”政策影响全球产业链格局
新质生产力系列 | 风电:深远海政策接连催化,海风乘势待发
法律声明:
本公众订阅号(微信号:中证鹏元评级)为中证鹏元资信评估股份有限公司(以下简称:中证鹏元)运营的唯一官方订阅号,市场有风险,投资需谨慎。在任何情况下,本订阅号所载信息或所表述的意见并不构成对任何人的投资建议,对任何因直接或间接使用本订阅号刊载的信息和内容或者据此进行投资所造成的一切后果或损失,中证鹏元不承担任何法律责任。
本订阅号所发布的原创报告所采用的数据均来自合规渠道,通过合理分析得出结论,结论不受其它任何第三方的授意、影响,特此声明。报告中观点仅是相关研究人员根据相关公开资料作出的分析和判断,并不代表公司观点。

 海量资讯、精准解读,尽在新浪财经APP
海量资讯、精准解读,尽在新浪财经APP
中金汇融配资提示:文章来自网络,不代表本站观点。